近日,轮盘在线
集成攻关大平台氮化物研究团队在氢化物气相外延(HVPE)技术制备4英寸氮化镓(GaN)单晶衬底方面取得重要学术进展,相关研究以“Hydride Vapor Phase Epitaxy Flow Field Design and Uniformity Optimization for 4-in. Gallium Nitride Crystal Substrates”为题,发表于国际晶体生长领域期刊《Crystal Growth & Design》。2024级硕士研究生刘庆斌为论文第一作者,王忠新、张雷与王守志为共同通讯作者,山东大学为第一通讯单位。
HVPE技术因具备超过100 μm/h的高生长速率,是目前制备高质量大尺寸GaN单晶衬底的主流商业化技术。然而,随着衬底尺寸的不断扩大,流场均匀性控制难度剧增,常规单参数优化易引发涡流及晶体开裂等缺陷。为解决这一难题,团队利用计算流体动力学(CFD)对垂直HVPE反应器进行三维建模。该模型系统研究了前驱体(GaCl)流量、隔离气流量、NH3流量以及衬底位置对GaN沉积速率和均匀性的影响。研究发现,流场内各参数间存在着复杂的相互制约关系:GaCl流量过高会导致边缘供给不足,NH3流量偏低会降低整体沉积效率。此外,喷嘴与衬底距离过近会产生“中心厚、边缘薄”的严重畸变;距离过远则会使沉积速率显著下降。通过协同调控轴向质量传输与径向表面扩散,团队最终确立了核心工艺参数的最佳平衡点。优化后的流场成功实现了平稳均匀的层流覆盖,兼顾了高生长速率与极低的不均匀性。
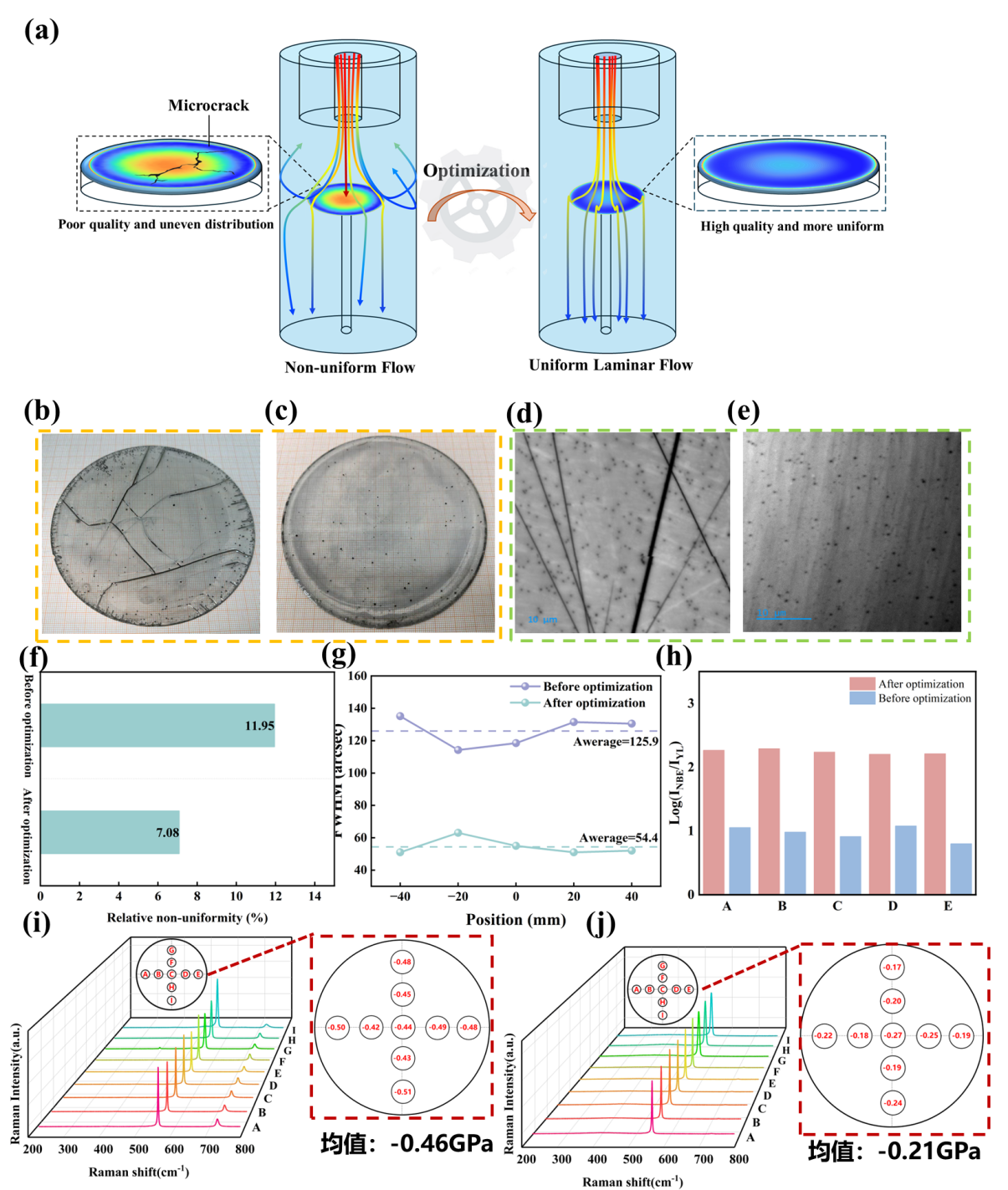
图:(a)基于CFD仿真的垂直HVPE反应室流场优化示意图,(b)优化前(c)优化后的GaN晶体光学图片,(d)优化前和(e)优化后GaN的表面CL图像(f)优化前后直径方向五点厚度分布以及(g)相对不均匀性,(h)优化后后GaN五点(A-E)PL图谱五点对应的INBE/IYL对数比值对比,(i)优化前和(j)优化后GaN九点(A-I)Raman图谱以及通过九点对应的E2(High)偏移计算出的表面应力分布。
为验证数值模拟的有效性,研究团队基于最优参数在HVPE系统中开展了4英寸GaN晶体生长实验。结果表明,优化后的晶片微裂纹与表面凹坑显著减少,外观高度平整透明,相对厚度不均匀性从11.95%降至7.06%,位错密度从9.1×106cm-2下降至2.4×106cm-2,半峰宽降至54.4arcsec。此外,光致发光(PL)光谱证实与缺陷相关的黄光带(YL)被极大抑制,对数比值log(INBE/IYL)从1左右提升至2左右。多点拉曼光谱则表明,全片平均应力从-0.46 GPa缓解至-0.21 GPa,同时代表杂质的A1(LO)峰在优化后基本消失。该项研究有效抑制了多晶夹杂、微裂纹和表面凹坑的形成,为大尺寸GaN单晶衬底的低成本、工业化制备提供了可靠的工艺路线。